
随着微电子封装技术不断发展,高密度三维集成等先进集成形态应用愈加广泛,由此带来的更高热流密度与更强局部热点效应,使封装热管理面临更严苛挑战。封装散热路径中的各结构表面即便经过加工仍存在一定的表面粗糙度,直接贴合会因空气滞留显著抬升界面热阻,因此需要引入热界面材料(Thermal Interface Material,TIM)填充空隙、排出空气并增加真实接触面积,以降低接触热阻并加快热点热量传导,以防止过热引发的性能降频、可靠性退化及器件失效风险。在高热流密度条件下,这一界面层的热阻、厚度一致性与长期稳定性要求也随之显著提高。
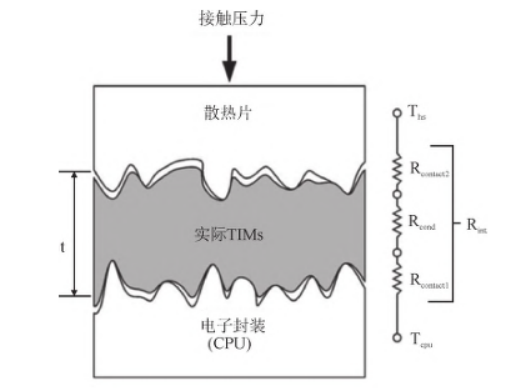
界面热阻示意图
在热界面材料的应用中,通常按其所在散热路径的层级进行区分:TIM1分配在倒装芯片与散热盖/封装盖板(lid/IHS)之间;TIM2分配在成品封装、组件或模块与外部散热器(如金属外壳、散热片、均热板或冷板)之间;而在无盖(lidless)结构中,芯片直接与散热器接触,其间界面材料常被称为TIM1.5。从热路径角度看,典型链路可概括为:芯片/结区→TIM1→散热盖(IHS)→TIM2→散热器→环境。
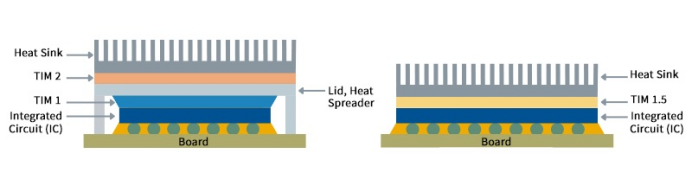
TIM1 TIM2(有顶盖)及TIM1.5(无顶盖)示意图
其中,TIM1由于最靠近热源且承受最高热流密度,其界面热阻对结温的影响最为直接。相较于后级散热结构可通过增大换热面积、降低热沉热阻或升级冷却方式进行一定补偿,TIM1引入的温升发生在热路径前端,往往更难被后端“弥补”。因此,TIM1可被视为“芯片到散热盖”的第一道关键热通道,其材料选型与工艺控制在很大程度上决定了封装热通道的下限。
从工程角度看,TIM1对热界面材料的要求可概括为“三个关键词”:低热阻、可控性、长期稳定。一方面,材料需在芯片与散热盖之间实现充分润湿与填隙,在尽可能薄且均匀的界面厚度(BLT)下形成连续导热通路,以获得较低的等效界面热阻;另一方面,材料与工艺窗口必须可量产复现,能够抑制空洞、局部干点与脱层等缺陷带来的热阻离散;同时在热循环与长期工作温度下保持界面完整与性能稳定,避免泵出、干涸或界面退化导致热阻随时间上升。
按照材料形态与传热机理,TIM1常见的实现路线可概括为几类:金属焊料型TIM(如铟/铟合金焊料)、聚合物基导热材料(导热膏/导热凝胶/固化型导热胶)、相变金属合金 (PCMA)。
1、金属焊料型TIM(铟及其合金)
铟及其合金常用于TIM1焊料型方案,其核心价值在于同时具备“高导热+高顺应性”。一方面,铟具有较高的热导率(约 86 W/m·K),有利于降低界面传热热阻;另一方面,铟质地柔软、延展性优异,能够顺应芯片与散热盖两接触表面的微观不平整,并在回流/热压与装配压力作用下充分变形,填充die与IHS之间的微观空隙,从而提升实际接触面积并降低等效界面热阻。更重要的是,铟具备室温蠕变能力,可在器件长期工作与热胀冷缩循环中发生微观形变,在一定程度上维持紧密接触、补偿界面微小变化;同时其柔软性有助于缓冲硅与铜盖板之间的CTE失配应力,并通过蠕变实现应力松弛,从而改善热循环可靠性。
需要注意的是,铟焊料TIM1成本较高、工艺窗口相对苛刻,且空洞控制对热性能高度敏感——焊层空洞会直接抬升界面热阻并诱发热点温升,因此需在界面金属化、压力、温度曲线及检测手段(如X-ray/超声)上进行系统控制与验证。
2、聚合物基导热材料(导热膏/导热凝胶/固化型导热胶)
聚合物基TIM1的核心优势在于工艺适配性强与应力缓冲能力。这类材料通常以有机硅、环氧等为基体,通过填充高导热填料构建导热网络,能够在装配压力下较好地润湿并填充芯片与散热盖之间的微观空隙,从而降低接触热阻;同时其相对较低的模量有助于吸收界面应力与装配公差,对翘曲、表面粗糙度和压力分布不均具有一定“容忍度”,更利于规模化制造与成本控制。
需要注意的是,聚合物体系的性能更容易受界面厚度(BLT)与服役环境影响:在长期高温与温度循环条件下,部分材料可能出现泵出、干涸/挥发、填料迁移或界面粘接衰减,导致覆盖率下降与热阻漂移;因此其工程化落地通常依赖于BLT窗口锁定、界面清洁与装配压力控制,以及面向寿命工况的可靠性验证来约束热阻随时间的变化。
3、相变金属合金 (PCMA)
相变金属合金(PCMA)属于相变类TIM的一种路线,其核心思路是利用材料在目标温区的软化或相变行为,提升界面润湿与铺展能力,从而增加真实接触面积并降低界面热阻。相较于常温下高流动性的界面材料,PCMA在装配阶段通常更易保持形态可控;而在达到工作温区后,可借助相变/软化实现“自适应”填充微观间隙,改善贴合质量并降低由表面不平整引起的接触热阻。
需要注意的是,PCMA路线的关键在于相变温区与实际工况匹配以及热循环后的界面稳定性:若温区不匹配,难以获得预期的界面改善;若在温循与长期高温下发生迁移、重分布或界面劣化,则可能引起覆盖率下降与热阻漂移。因此PCMA的工程应用通常需要结合温度谱、装配压力与界面体系进行窗口设计,并通过温循/老化等试验验证其热阻稳定性与界面可靠性。
编辑整理:粉体圈Alpha
