
今年初,英伟达在拉斯维加斯的国际消费电子展(CES)上官宣公司下一代基于Vera Rubin架构的旗舰GPU,将采用一项突破性的散热方案——“钻石铜复合散热基板结合45℃温水直液冷”,并称其能将GPU核心 hotspot(热点温度)降低超过50℃,为算力密度再提升一个数量级扫清障碍。不久后,英伟达CEO黄仁勋更是来华与超赢钻石科技创始人朱艳辉举行会谈,就金刚石铜复合材料等探索合作可能。
金刚石/铜复合材料完美融合了金刚石(热导率高达1200-2000 W/mK)的极速导热能力,以及金属铜的优良加工性与适中的成本,其热导率可轻松突破800 W/mK,是纯铜的两倍以上,同时热膨胀系数可调整至与芯片材料匹配,堪称高功率密度电子器件散热的理想材料。然而这种理想材料要实现规模应用,这几大制备关键点必须突破。
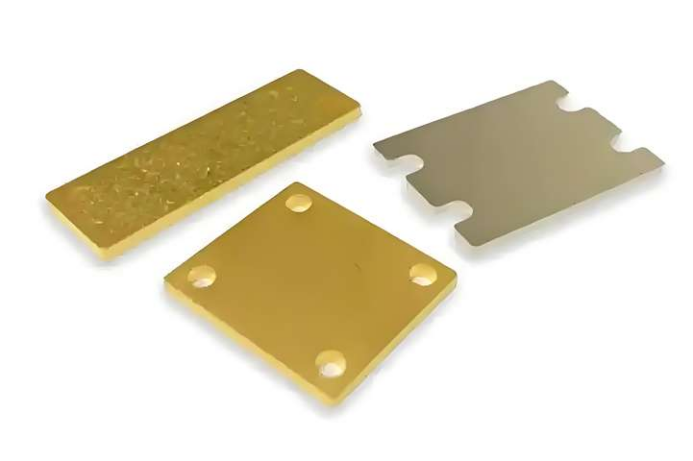
来源:网络
关键点一:界面工程——打通导热桥梁
金刚石是典型的共价键晶体,表面能低,呈现化学惰性;而铜是金属键,两者界面润湿性极差。熔融的铜液在金刚石表面就像水珠在荷叶上,无法铺展浸润。这导致在复合材料中,金刚石与铜之间存在着大量微观的、充满空气的缝隙,形成巨大的界面热阻,热量传导至此便严重“堵车”,导致复合材料的热导率受到严重限制。因此,必须在金刚石与铜之间搭建一座高效的“导热桥梁”,解决两者之间的界面问题。
1、基体合金化
该方法是在铜基体中微量添加铬、硼、锆等合金元素。在制备过程中,这些活性元素会扩散至金刚石界面并与之反应,原位生成碳化物界面层,一方面与金刚石形成强化学键,另一方面又能与铜基体良好地互溶或润湿,大幅降低界面热阻。此方法工艺相对简单,只需将铜和合金粉末预先合金化,再采用铜合金粉末进行制备金 刚石/铜复合材料即可,但对元素种类、添加量及工艺控制要求极高。通常,所选合金元素需要既可溶于熔融金属,能够与基体金属形成合金;但溶解度又不能太高以至于大幅降低铜基体的性能,如B、Cr、Ti、Si等,同时添加量要求接近碳化物形成所需的极限值,太高则会显著降低复合材料的热导率,太低则界面增强作用不明显。
2、金刚石表面金属化
通过磁控溅射、化学镀、真空蒸发镀等技术在金刚石颗粒表面包裹一层极薄的(通常为几十到几百纳米)活性金属层,如钨(W)、钼(Mo)、铬(Cr)或钛(Ti)。在后续的高温制备过程中,这层金属会与金刚石表面的碳原子反应,生成稳定的碳化物(如WC、Cr3C2)。相比基体合金化,金刚石表面金属化可以通过调控镀覆参数直接控制镀层的成分、厚度等,使金属 或碳化物镀层与金刚石和铜形成良好的界面结合,实现更优异的热导率。比如,超赢钻石就攻克了该核心技术,实现钻石铜复合材料热导率突破1000 W/m·K,达到国际领先水平。


碳化物镀层与铜的润湿角
关键点二:填充优化——构建高密度导热网络
金刚石/铜复合材料中,金刚石是导热的主体,其体积分数直接决定了材料热导率的上限。然而,单纯堆积金刚石颗粒,颗粒间必然存在大量空隙——这些空隙若被铜填充不足,就成了导热通路上的“断路点”。因此,在保证金刚石颗粒均匀分布的前提下,最大化金刚石的体积分数,并让铜液完全填充所有间隙,形成三维连通的导热网络,也是提高复合材料热导率的一大关键点。
1、优化制备工艺
当前,金刚石/铜的主流制备技术是粉末冶金法,虽工艺成熟,成本相对可控,但金刚石体积分数难以突破 75%。熔渗法是实现高填充率的首选工艺,该工艺将金刚石颗粒与少量粘结剂预先经压制、脱胶、烧结后形成具有三维连通孔隙的预制体骨架,然后在真空或高压气氛下将熔融铜液“压入”骨架孔隙中,最终可得到金刚石体积分数高,导热性能接近金刚石本身,且产品无明显界面缺陷,热稳定性优异的金刚石/铜复合材料。
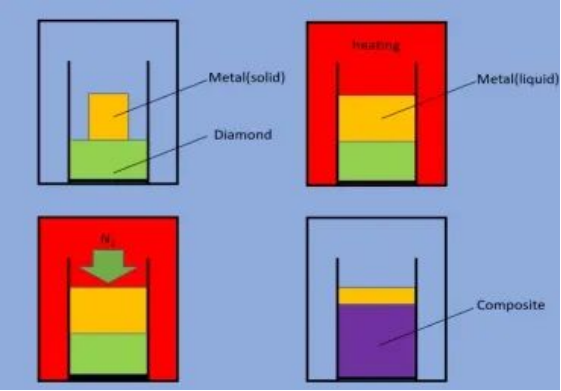
气压浸渗法流程图(来源:、王硕.电子封装用金刚石铜复合材料的制备及性能研究[D].东南大学.)
2、梯度粒径配比
单一粒径的金刚石颗粒堆积,颗粒间必然留有较大空隙。通过合适的颗粒级配,让粗颗粒充当骨架,让细颗粒填充粗颗粒之间的间隙,是提高金刚石堆积密度的经典策略。
关键点三:致密化——消除微观热阻
金刚石硬度极高、难以变形,且与铜的热膨胀系数相差近5倍。在制备冷却过程中,巨大的收缩应力极易在界面处或铜基体内产生微裂纹和孔隙等缺陷,这些缺陷也会中断热量传导路径。致密度作为衡量材料内部缺陷水平的标尺,成为了金刚石/铜复合材料保证超高热导率的最后一关,而这关键在于对烧结过程的热应力进行管控。
1、优化烧结/熔渗工艺曲线:
在升降温过程中,通过设计缓慢、分段、阶梯式的工艺曲线,尤其是控制从熔渗温度(通常900-1000℃)到室温的冷却速率,让铜基体得以缓释热应力,逐步适应与金刚石的收缩差,从而有效抑制裂纹萌生。
2、后处理
对于已成形的复合材料坯料,热等静压是消除残余微观孔隙的有效手段。在高温和超高静水压力的共同作用下,基体铜发生屈服,孔隙周围的材料在压力驱动下向孔隙中心塑性流动,使孔隙体积收缩、界面逐渐贴合,不仅微米级及亚微米级孔隙的孔隙可被消除,原先因热膨胀不匹配而产生的界面微裂纹也在高温高压下重新冶金结合,界面热阻显著下降。
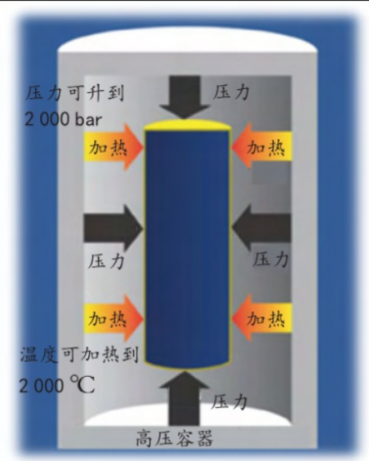
热等静压原理
小结
界面、填充率与致密度是金刚石/铜复合导热材料必须依次击破的三道关卡:任何一环的短板都将扼住“热导率”的咽喉。值得期待的是,部分国内企业已在表面金属化、熔渗致密化等环节取得国际领先的突破,将热导率推升至1000 W/mK以上,让“钻石散热”从概念走向工程。可以预见,随着界面设计技术不断精进、制备成本随规模化减少,金刚石/铜有望成为高功率电子器件散热的基础配置,不仅为英伟达的下一个万卡集群提供冷源,更将为后摩尔时代的算力跃迁铺就一条宽阔的热管理“高速公路”。
参考文献:
1、崔露露.金刚石增强铜基导热材料研究进展[J].中国金属通报.
2、唐伟,杨子豪,马毓,等.金刚石/铜复合材料的界面调控与导热性能研究进展[J/OL].金刚石与磨料磨具工程.
粉体圈Corange整理
