
日前,日本森村集团旗下则武株式会社(Noritake)宣布开发了一种用于玻璃基板通孔(TGV)工艺的新型银浆,以其为基础材料的新型布线工艺被视为传统镀铜工艺的有力竞争者,不仅效率大为提升,而且还能避免镀铜作业常见的裂纹产生问题。本文就此详细展开说明,面向AI时代的新型封装工艺给银基浆料带来哪些机遇和挑战。
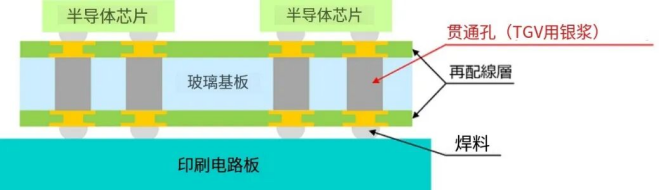
3D封装中TGV工艺及纳米银浆的应用示意图
AI时代到来,相关硬件设备领先企业为继续提升服务器性能,提出3D封装与玻璃基板路线,并且经历工艺和材料的不断改进,路线也已基本确立。如上图所示,在玻璃基板进行激光打孔(TGV),以此形成连接“芯片层”的垂直通道,再以导电材料(传统镀铜vs新型银浆)建立起层间电气连接和散热路径——业界对连接和路径的要求是兼顾“低电阻”与“可靠性”,这样才能形成高效和稳定的信号传输。
传统镀铜工艺及缺陷
简单说就是通过电化学沉积,使铜从离子溶液中析出沉积填充通孔。实际操作时,需经过清洗→活化→化学镀种子层→电镀铜→表面研磨等多步工序,由于电镀速度缓慢,流速或助剂不均等都可能导致填充不致密,后续高热工况下容易因热应力导致薄脆玻璃基板产生裂纹。
新型银浆工艺与提升
简单说就是将高固含量、低粘度的银浆通过印刷或真空压力直接注入通孔,然后加热烧结,使银颗粒熔融形成致密导体。它简化了镀铜的所有预处理工序,填充和烧结作业也非常高效。消除镀铜缺陷的同时,也更好适配了玻璃基板,并且设计相对灵活(可局部进行)。

TGV用银浆
但是,新型银浆开发存在较高的粉体技术和配方门槛——虽然纯银的本征导电性优于纯铜,但在TGV互连的实际制备中,“烧结银浆形成的导电结构的有效电阻率,目前通常高于成熟工艺制备的电镀铜互连的有效电阻率”。原因是传统镀铜通过离子沉积,能在通孔内生长出相对连续、致密的金属柱,结构接近块体金属,因此其电阻率可以做到非常接近纯铜的理论值;而由微纳米银颗粒、有机溶剂和粘结剂混合而成的银浆,烧结时银颗粒之间通过颈部长大连接,会留下微观孔隙和大量晶界,这导致电流路径曲折,电子散射严重,因此有效电阻率远高于纯银。
Noritake推出产品专门提到通过独特的成分设计和颗粒分散技术,最大限度地增加了银浆中的银填充量,能够同时保持与传统铜镀层技术相同的电阻值,并大幅提高了布线工艺的效率,抑制了玻璃基板裂纹的产生。
小结
在3D封装向更高密度、异质集成、系统级性能演进的道路上,玻璃基板与TGV是关键技术。新型导电银浆的出现,为TGV金属化提供了传统镀铜之外的第二条技术路径,这是银基材料高端应用的机遇,同时也是挑战。
粉体圈启东
