
最近,Materials Today Physics(今日材料物理学)期刊在线定稿发表了来自中南大学的最新研究成果,科研团队通过多级界面层设计开发了导热能力、热膨胀匹配和热稳定性全面提升的金刚石/Cu复合材料。
论文地址:https://doi.org/10.1016/j.mtphys.2025.101818

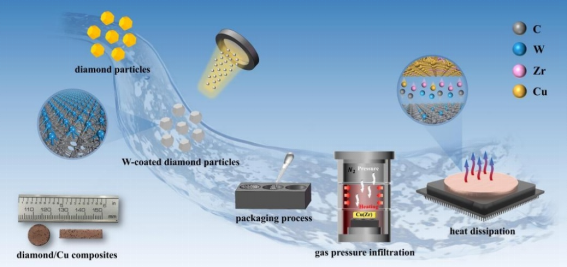
金刚石/Cu复合材料制备渲染示意图
高性能计算芯片的多功能集成和微型化的发展加剧了封装材料的热管理挑战。铜(Cu)作为一种低廉且高可加工性的金属,是导电和导热应用的主力材料。近年来,随着合成金刚石技术高速发展使其成本下降,高达2200W∙m热导率卓越特性的金刚石导热应用自然进入业内视野。金刚石/Cu复合材料也备受关注。在之前一些相关研究中,通过引入界面过渡层可以耦合厚度控制来获得优异的热性能,但金刚石/Cu复合材料的热膨胀系数(CTE)仍然远未达到先进的电子封装标准,并且在实际应用中导热能力的衰减仍然是限制其工程应用的主要障碍。
科研团队在本次研究中,通过磁控溅射和气体压力辅助浸渗(GPI)技术,成功地在金刚石/Cu复合材料中引入了由WC层和W-ZrC固溶体(WC-(Zr,W)C)组成的连续多层界面层。最终获得高性能复合材料,热导率743W/m·K,323K(约50℃)下热膨胀系数4.5×10−6K−1,大气环境循环百次后热扩散系数仅下降20.7%。这项工作不仅解决了金刚石/Cu复合材料的工程应用挑战,深入理解了增强机制,还为热管理复合材料中的界面层设计提供了新的视角。
编译 YUXI
