
近日,日本Patentix公司宣布在新型半导体材料——金红石型二氧化锗(rutile-type GeO2,简称r-GeO2)薄膜上,通过离子注入方式成功引入施主杂质锑(Sb),首次实现了其n型导电性。这一突破为下一代高耐压、高效率功率半导体器件的设计与制造提供了全新材料选项。
作为一种具备4.68 eV超宽禁带的氧化物半导体,r-GeO2在理论上优于SiC和GaN,具备更高的击穿电压与热稳定性。然而,长期以来该材料在电子掺杂方面面临挑战,限制了其实际应用进展。
Patentix此前已基于自研PhantomSVD薄膜沉积技术,在成膜过程中引入锑元素,实现了r-GeO2的n型导电调控,并成功验证其在肖特基势垒二极管(SBD)中的应用可行性。
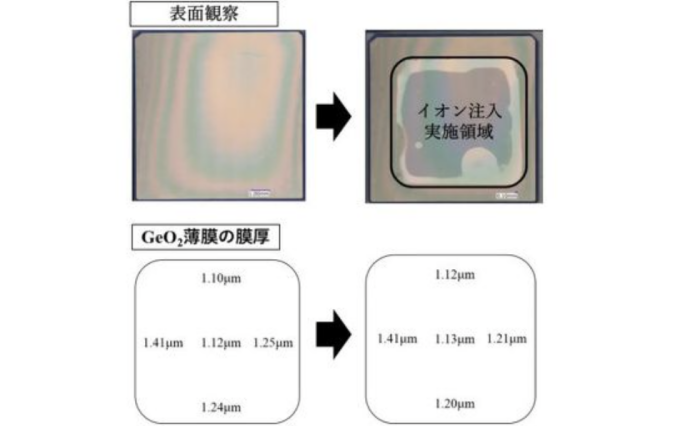
r-GeO2薄膜在离子注入前(左)和后(右)的表面和厚度
此次进一步采用离子注入法,将锑掺杂精准地引入至已沉积好的r-GeO2薄膜中,具备更高的掺杂空间分辨率和浓度控制能力。实验结果显示,注入区域保持晶体结构稳定,且片电阻明显下降,说明施主杂质已被激活,有效提升了导电性能。
后续通过C-V(电容-电压)特性分析确认了n型导电行为,并揭示掺杂杂质主要分布在薄膜表面附近。未来,Patentix将进一步评估锑的具体注入浓度及活化效率,持续推动r-GeO2材料体系在高性能功率器件中的工程化应用。
粉体圈Coco编译
