
近日,由香港大学(港大)工程学院机械工程系陆洋教授与北京科技大学新材料技术研究院李成明教授共同领导的研究团队,成功研制出直径达5英寸超硬金刚石晶圆,厚度仅3毫米,硬度超过200 GPa,较传统人造金刚石硬度翻倍,突破了半导体材料技术瓶颈。这项科研突破为超硬金刚石在精密加工、半导体技术以及航空航天工程等高规格应用领域的发展奠定了重要基础。

金刚石:半导体材料的“终极形态”
金刚石被视为半导体材料的“终极形态”,其导热性能和耐辐射性能远超硅与碳化硅等传统半导体材料。然而,传统高温高压(HPHT)和化学气相沉积(CVD)技术始终无法兼顾大尺寸与高硬度这两项关键指标。
创新工艺实现关键突破
为克服上述限制,团队创新采用“微波等离子体化学气相沉积(MPCVD)”技术,配合高频循环脉冲氮掺杂工艺,在金刚石生长过程中构建动态非平衡环境,成功实现英寸级超硬晶圆量产的关键突破。
通过在等离子体中以高频方式交替引入氮源,使等离子体活性基团的组成和生长温度在极短时间内持续波动,从而打破传统稳定生长模式的限制。这种动态调控机制不仅强化了表面重构与缺陷过程,还有效促进了特殊微观结构的形成,使金刚石在保持高纯度和高致密度的同时,为超大尺寸超硬材料的规模化生长提供了全新技术途径。
性能测试数据亮眼
测试显示,该晶圆耐磨性达普通多晶金刚石的7倍,维氏硬度高达208.3 GPa,是常规金刚石硬度的2倍,并能在单晶金刚石表面留下清晰划痕。
通过高倍电子显微镜分析,团队发现晶圆内部形成了密度高达4.3×1012cm-2的三维互锁堆垛层错网络结构,可有效抑制位错运动。此外,掺氮生长技术同样适用于复杂三维结构表面,可直接应用于刀具与机械元件,为高端现代电子工业提供全新材料方案。
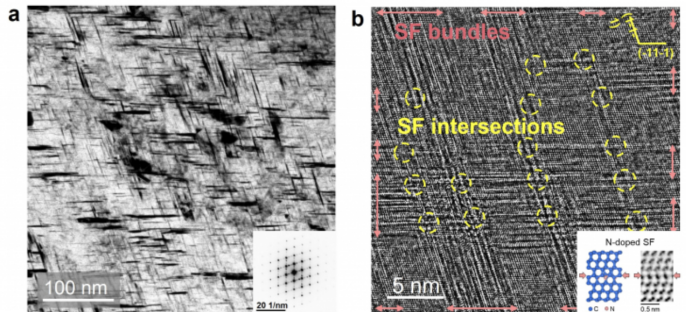
研究展望
陆洋教授表示:“这项大尺寸超硬金刚石晶圆的突破,将为金刚石在极端环境探测、先进制造业及半导体热管理等领域的应用打开新局面。我们期待新技术为第三代及第四代半导体材料的发展注入强心针。”
相关研究成果已发表于国际顶级期刊《自然—通讯》(Nature Communications),论文标题为《Inch-scale Ultrahard Diamond Wafer with 200 GPa Hardness via High-Frequency Pulsed Local Non-Equilibrium Growth》。
粉体圈整理
