
Resonac(原日本昭和电工)是半导体封装领军企业,其在2024年倡导日、美两国领先材料和装备企业组成US-JOINT(Jisso Open Innovation Network of Tops),意在主导新型半导体封装关键技术和市场。所谓下一代半导体封装,包括2.5D(一种将多个芯片放置在单个基板上并将它们互连的技术)和3D(一种通过垂直堆叠的方式排列多个芯片的技术),而Resonac拥有多种在全球市场占有率最高的封装材料,自然拥有该领域内强大的号召力。本文聚焦整理部分Resonac公开的热管理技术和材料,如有疏漏,请留言补充,不胜感谢。
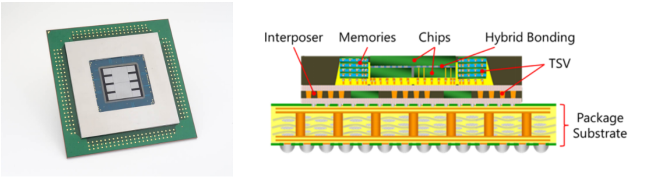
2.5D(左)与3D(右)封装示意图
以3D封装为例,由于垂直堆叠了多个芯片,发热密度自然也更高,散热除了考量结构设计,也必须提高封装材料的热导率,降低热阻。诸如此类,Resonac通过专门课题攻关,厘清开发逻辑继而推出相关封装产品。以下主要列出其从应用端出发,提出问题并解决问题的一些案例。
1、片状BN填料
问题:对散热材料、线路板生产商而言,用于热界面材料(TIM)和预浸料的导热填料广泛采用硅微粉、氢氧化铝等,但这些填料无法满足功率半导体、LED器件对高导热能力提升的诉求。
解决:Resonac开发了热传导率优异的鳞片状氮化硼(BN)填料,并进行改性处理以提高填料相容性,关键点就在于BN呈鳞片状,其端面上仅存在如羟基或氨基等反应性较高的官能团,因此表面处理被认为比较困难。Resonac推出通过化学方法进行大规模处理的“ST-BN”。
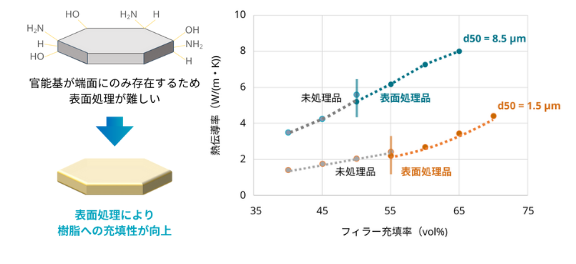
BN改性前后填充率与热导率变化示意
2、硅酮系聚合物涂层
问题:电子电路的防尘、防潮需要涂层保护,尤其需要防潮,否则会导致金属部件腐蚀和绝缘性能下降,由于工况往往处于高温,因此要兼顾耐高温性能。
解决:Resonac通过独特的树脂设计,使得聚合物链通过疏水基架桥,此外,加热时架桥基之间的架桥也会形成,坚固的涂层,实现耐热性和防潮性的兼顾,从而提高设备的可靠性。
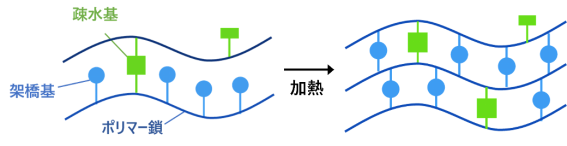
硅酮系涂层开发示意
3、石墨传热片
问题:半导体芯片的大型化使得安装温度和运行时的温升降温引起的弯曲比以往更大,热导材料从芯片上剥落的问题也日益突出。
解决:通过石墨填料在高粘性树脂基材中垂直排列制成半导体封装用热传导片,其兼具优异热传导率和由热引起的基板翘曲的灵活性,表现出25~45W/(m·K)的优异热传导性能,凭借其高热导率和柔韧性,抑制芯片和散热器之间的接触热阻上升。
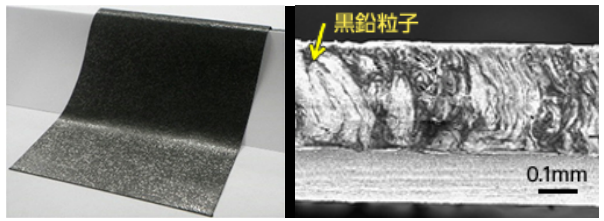
石墨垂直配向热传导片
4、铜键合浆料
问题:随着高效率的SiC功率模块的普及,包括芯片粘结材料和接合材料在内的构成部件,也需要高耐热、高散热和高可靠性。现阶段取代传统高铅焊料的,能够同时具备耐热性和散热性的以烧结银浆为主,但银在进一步提高模块的输出功率和小型化方面的可靠性不足。
解决:铜与银相比,具有更高的弹性率和屈服应力,且热膨胀系数较小。Resonac开发了在耐热性、散热性和可靠性方面都表现出色的烧结铜膏,保持与烧结银相同散热性的同时,提高SiC功率模块的可靠性。

如图所示:铜膏分两种:一种用于倒装芯片 bond(DIY 倒装芯片粘接),另一种用于大面积连接。热导率300 W/(m·K),与烧结银相当;比烧结银更高的硬度、更低的热膨胀系数;在175℃功率循环测试中,寿命比高铅焊料高约40倍,比烧结银高约5倍。
小结
从以上列出几个不同应用的热管理案例,还有本文未列出的,比如其最新开发的低热膨胀覆铜板,是解决大型先进封装因不同材料热膨胀系数差异而产生翘曲和应力的系统性答案,不难发现Resonac不仅提供高性能的单点材料,更致力于提供抑制热应力与翘曲的系统级解决方案。其凭借从基础填料到系统级封装基板的完整产品线,已成为应对2.5D/3D等先进封装散热挑战的核心材料供应商,被台积电、三星电子等顶级客户采用,用于高性能半导体制造。小编以为,在Resonac热管理能力的背后,其实是对封装可靠性物理机制的深刻理解,以及利用数字化工具进行材料创新和提供系统性解决方案的能力,您说呢?
启东
