
从芯片到器件和系统的工艺过程都称为电子封装,芯片只有经过封装才能成为一个完整的器件,才能具有特点的功能。半导体封装一般可分为4级:0级封装,晶圆的电路设计与制造;1级封装,芯片之间的相互连接;2级封装,元器件封装到电路板;3级封装,电路板组合在主板并形成最终电子产品。电子产品制备过程,封装占总成本30-60%。

4级封装:0级→1级→2级→3级
电子封装的主要功能有4个,①机械保护:机械支撑与保护,防潮/防尘/防振(气密封装);②电互联:供电、信号传输与控制;③散热、热匹配等(功率半导体、高温器件);④导光:降低光损耗,提高出光效率。
封装有4大功能的实现,实际上有很多和IC封装有关,比如说机械支撑,芯片要放在基板上面去;第二要实现电互连,基板上面有很多电路层;第三解决散热问题,特别对于功率器件而言。目前常用基板分为三大类,第一类就是高分子树脂基板,第二类就是金属基板,底下是个金属层,上面是一个线路层,但是中间有一个绝缘层。第三类就是陶瓷基板,也就是我们今天的重点。陶瓷材料本身具有热导率高、耐热性好、高绝缘、高强度、与芯片材料热匹配等性能,非常适合作为功率器件封装基板,目前已在半导体照明、激光与光通信、航空航天、汽车电子、深海钻探等领域得到广泛应用。陶瓷基板又称陶瓷电路板,包括陶瓷基片和金属线路层等。
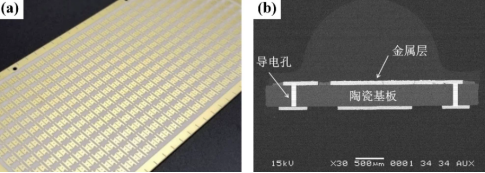
一、陶瓷基片材料
目前,常用电子封装陶瓷基片材料包括氧化铝(Al2O3)、氮化铝(AlN)、氮化硅(Si3N4)、氧化铍(BeO)等。下面分别介绍其性能与技术特点。
1、氧化铝
氧化铝陶瓷呈白色,热导率为20-30W/(m·K),25°C~200°C温度范围内热膨胀系数为7.0×10-6/°C~8.0×10-6/°C,弹性模量约为300GPa,抗弯强度为300MPa~400MPa,介电常数为10。氧化铝陶瓷具有原料来源丰富、价格低廉、绝缘性高、耐热冲击、抗化学腐蚀及机械强度高等优点,是一种综合性能较好的陶瓷基片材料,占陶瓷基片材料总量的80%以上。但由于其热导率相对较低(99%氧化铝热导率约为30W/(m·K),热膨胀系数较高,一般应用在汽车电子、半导体照明、电气设备等领域。

深色氧化铝陶瓷封装基板
氧化铝陶瓷基片成型方法主要有轧膜法、流延法和凝胶注膜法等。其中后两种方法采用去离子水代替有机溶剂,既可降低成本,也有利于环保,是Al2O3陶瓷片制备主要研究方向之一。

白色氧化铝陶瓷封装基板
相关阅读:
2、氮化铝
氮化铝材料呈灰白色,属于六方晶系,是以[AlN4]四面体为结构单元的纤锌矿型共价键化合物。该结构决定了其具有优良的热学、电学和力学性能。AlN陶瓷理论热导率可达320W/(m·K),其商用产品热导率一般为180W/(m·K)~260W/(m·K)[9],25°C~200°C温度范围内热膨胀系数为4×10-6/°C(与Si和GaAs等半导体芯片材料基本匹配),弹性模量为310GPa,抗弯强度为300MPa~340MPa,介电常数为8~10。

氮化铝陶瓷基板
氮化铝陶瓷热导率为氧化铝陶瓷的6~8倍,但热膨胀系数只有其50%,此外还具有绝缘强度高、介电常数低、耐腐蚀性好等优势。除了成本较高外,氮化铝陶瓷综合性能均优于氧化铝陶瓷,是一种非常理想的电子封装基片材料,尤其适用于导热性能要求较高的领域。
相关阅读:
3、氮化硅陶瓷
Si3N4具有三种晶体结构,分别是α相、β相和γ相(其中α与β相是最常见形态),均为六方结构,其粉料与基片呈灰白色,如下图所示。Si3N4陶瓷基片弹性模量为320GPa,抗弯强度为920MPa,热膨胀系数仅为3.2×10-6/°C,介电常数为9.4,具有硬度大、强度高、热膨胀系数小、耐腐蚀性高等优势。由于Si3N4陶瓷晶体结构复杂,对声子散射较大,因此早期研究认为其热导率低,如Si3N4轴承球、结构件等产品热导率只有15W/(m·K)~30W/(m·K)。

TOSHIBA高导热氮化硅基板
后来科学家通过经典固体传输理论计算发现,Si3N4材料热导率低的主要原因与晶格内缺陷、杂质等有关,并预测其理论值最高可达320W/(m·K)。之后,许多科学家在提高Si3N4材料热导率方面出现了大量的研究,通过工艺优化,氮化硅陶瓷热导率不断提高,目前已突破177W/(m·K)。Si3N4陶瓷传热机制同样为声子传热。晶格中的杂质往往伴随着空位、位错等结构缺陷,降低了声子平均自由程,导致热导率降低,因此制备高纯粉体是制备高热导率Si3N4陶瓷的关键。
目在现有可作为基板材料使用的陶瓷材料中,Si3N4陶瓷抗弯强度高(大于800MPa),耐磨性好,是综合机械性能最好的陶瓷材料,同时其热膨胀系数最小,因而被认为是一种很有潜力的功率器件封装基片材料。但是其制备工艺复杂,成本较高,热导率偏低,主要适合应用于强度要求较高但散热要求不高的领域。
相关阅读:
4、氧化铍
BeO材料密度低,具有纤锌矿型和强共价键结构,其粉末与基片均为白色(见下图)。BeO导热率是Al2O3的十几倍,适用于大功率电路,如纯度为99%的BeO陶瓷室温热导率可达310W/(m·K);其禁带宽度高达10.6eV,介电常数低至6.7,可用于高频电路;弹性模量为350GPa,抗弯强度为200MPa,具有良好的综合性能。BeO基板基本上采用干压法制作,此外也可在其中添加微量的MgO及Al2O3等利用生片法制作BeO基板。
但优秀的它还是有些不足之处的,由于BeO粉末的毒性,存在环境问题,在日本不允许生产BeO基板,只能从美国进口;BeO烧结温度高达1900°C以上,生产成本高;BeO热导率随着温度升高而降低,如在0°C~600°C温度范围内,BeO陶瓷平均热导率为206.67W/(m·K),但当温度升高到800°C时,其热导率降低为十分之一,上述原因限制了氧化铍的推广应用。
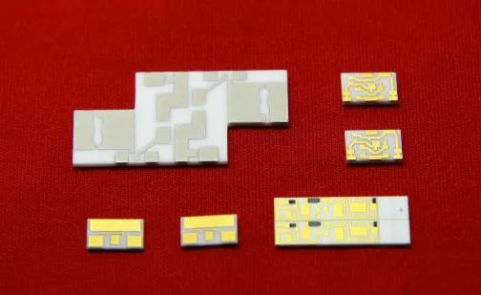
氧化铍陶瓷基板
但在某些大功率、高频半导体器件以及航空电子设备和卫星通讯中,为了追求高导热和理想高频特性,仍在采用BeO陶瓷基片。目前,美国是全球主要的BeO陶瓷基板生产和消费国,福特和通用等汽车公司在点火装置中大量使用BeO陶瓷基板。
相关阅读:
1、这款军工专用的陶瓷材料真是深藏不露(不用猜了就是氧化铍哈哈)
5、其他
除了上述陶瓷材料外,碳化硅(SiC)、氮化硼(BN)等也都可作为陶瓷基片材料。其中,SiC单晶材料室温热导率可达490W/(m·K),但SiC多晶体热导率仅为67W/(m·K)。此外,SiC材料介电常数为40,是AlN陶瓷的4倍,限制了其高频应用。BN材料具有较好的综合性能,但作为基片材料,它没有突出优点,且价格昂贵,与半导体材料热膨胀系数也不匹配。
相关阅读:
1)常见陶瓷基板概述
总体而言,陶瓷基板在功率器件封装中占据举足轻重的作用,是各国重点研发的关键电子材料。 陶瓷基板核心技术研发包括陶瓷粉料、陶瓷基片及陶瓷基板制备技术等都是非常值得我们关注的领域。但前文也有说,陶瓷基板由基片及金属线路层组成,因此,除了要知道陶瓷基片有啥材质,那如何做成板板呢?上文也为大家展示了部分已经金属化的陶瓷基板产品图片,下期小编与大家一起探讨一下各种不同类型的陶瓷基板的工艺路线,关注粉体圈,持续更新更多精彩文章哦。
编辑:粉体圈Alpha
版权声明:
本文为粉体圈原创作品,未经许可,不得转载,也不得歪曲、篡改或复制本文内容,否则本公司将依法追究法律责任。
