
在现代半导体产业中,芯片制程不断微缩,封装密度持续提升,芯片不仅面临着更高的散热密度,更是同时面临着信号完整性、机械强度等多重考验,而氧化铝作为芯片与基板之间环氧塑封料的重要功能填料,其中天然存在的铀、钍等放射性杂质会释放α粒子,这些粒子穿透力虽弱,却能穿透芯片封装材料,干扰存储单元,导致存储单元发生“软错误”,即会损坏所存储的数据或所涉电路的状态,在数据中心、自动驾驶、航空航天等对可靠性要求苛刻的场景,一次软错误可能意味着巨大的经济损失甚至安全事故。在此背景下,Low-α射线球形氧化铝成为了决定先进封装成败的关键材料。然而,由于其制备门槛极高,这项技术长期被日本企业垄断。国产企业要打破这一局面,面临的是一场从工艺到理念的全面突围。
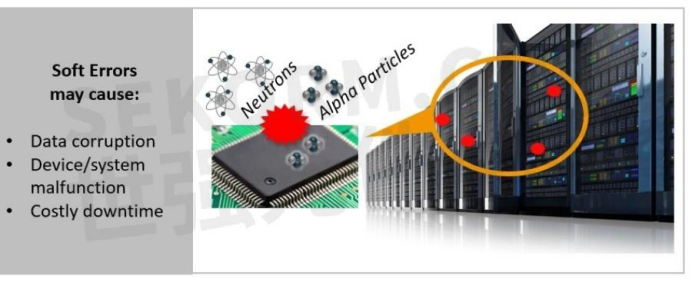
Low-α射线球形氧化铝制备难在哪:日企垄断下的高墙
当前,全球Low-α射线球形氧化铝市场呈现出高度集中的竞争格局。长期以来,日本企业凭借先发优势和深厚的技术积累,牢牢占据着高端市场的主导地位,其中日本雅都玛作为全球最早实现low α射线球形氧化铝产业化的企业,在产品纯度、球形度、粒度分布控制等方面建立了极高的技术壁垒,主要供应HBM封装等高端芯片市场。
据专利信息显示,日本雅都玛采用的技术为汽化金属燃烧法(VMC),是将铀(U)和钍(Th)含量小于1ppb的高纯铝粉置于高纯石墨坩埚中熔化并雾化制取高纯度球形铝粉,再将铝粉通入含氧气流燃烧,最终得到Low-α射线球形氧化铝。在该过程中,由于采用原料为高纯金属铝,该技术天然避免了传统矿物提纯路线中放射性杂质的引入,同时由于金属铝的沸点低铀(U)和钍(Th),在汽化过程中可进一步脱去铀(U)和钍(Th)等杂质元素,目前,日本雅都玛所生产的铀、钍等放射性杂质的含量最低可控制在1ppb,产品α射线剂量可低至0.0001c/cm²hr,技术领先。

然而,这看似简单的过程却构成了难以逾越的技术门槛:
1、原材料纯度控制:需使用铀、钍含量低于1ppb的高纯铝粉。而高纯铝粉的制备本身就涉及复杂的冶炼、提纯工艺,当前国产5N铝锭的U/Th通常在5-20ppb,需要再经区域熔炼+偏析或三层液二次电解才能降到1ppb以下;
2、燃烧过程控制:粉在氧气中爆燃时,需精密控制燃烧温度、氧气流量、铝粉粒径及分布等参数,以确保生成的氧化铝颗粒形貌均匀、球形度高。而日本雅都玛在这方面有着丰富的经验,能够精确控制球形氧化铝的粒径分布,从亚微米级到数十微米级均可实现定制化生产。
3、工艺洁净度控制:VMC法需使用高纯石墨坩埚、高纯雾化气体及无污染氧化气体等专用设备,,且整套系统需要在无污染环境下运行,对设备材质和工艺洁净度提出严苛要求。
4、批次稳定性的严苛要求: 日本企业在质量管理体系上的精益求精,使其产品在长达数十年的供货周期中保持极高的批次稳定性。对于半导体领域的下游客户而言,更换填料供应商意味着整个封装工艺的重新调试和验证,成本极高。因此,即便知道日本产品价格昂贵,客户也往往倾向于维持原有供应链。
国产能否突围?
面对日本企业的先发优势,中国本土企业并非没有机会。随着AI算力需求带动的HBM封装热潮,华海诚科、飞凯材料等国内环氧塑封料厂商GMC材料的同步突破,以及国内半导体产业链自主可控的迫切需求,Low-α射线球形氧化铝的国产替代正在加速。目前,联瑞新材、壹石通、天马新材等企业构成了国产替代的第一梯队。
·联瑞新材:
联瑞新材是目前国产替代进程中的领跑者。作为国内电子级硅微粉头部生产商,公司已掌握Low-α射线球形氧化铝从原料到成品的全套无污染生产技术。

不同于日本雅都玛,联瑞新材采用的技术为无机酸溶液洗涤法,即先制备出高纯度的球形氧化铝后,再通过化学洗涤,使铀、钍等放射性元素以离子形式溶解进入液相,并使用高纯水反复洗涤粉体,以彻底去除残留的酸液和溶解的杂质离子。
凭借这一技术,联瑞新材已实现0.1-10μm多种规格低CUT点、U/Th含量低至ppb级的产品稳定量产,产品性能对标国际,目前,产品已通过三星SDI、住友电工等一级供应商间接供货SK海力士、英伟达等国际客户,并已于2025年获得境外客户批量订单,商业化进程在国内达领先水平。
·天马新材:
天马新材作为在氧化铝领域深耕20年的老牌企业,凭借扎实的研发实力和不断通过改造高端生产线提升的工艺精细化水平,天马新材也已掌握Low-α射线球形氧化铝核心技术,目前也可将U/Th含量可控制在5ppb以下,处于中试向产业化过渡阶段,并已通过台积电COWoS认证,同时积极与下游客户(包括海外头部电子材料企业)开展样品验证工作,有望在2026年下半年或2027年实现规模化供货。此外,天马新材也已将开发Low-α射线球形氧化铝产品过程中的自研创新技术应用至其他高端球形氧化铝粉体研发中,并形成了系列产品,目前也在同步推进及客户验证过程中。

·壹石通
壹石通作为国内“电池+半导体”双赛道无机非金属新材料领域的领军企业,规划了年产200吨的高端芯片封装用Low-α球形氧化铝产能,产品已于2025年持续推进客户端多批次验证,部分客户已实现样品级销售。目前针对重点客户的定制化需求,公司已完成产品型号品类的扩充与完善,并持续送样验证,推动市场导入进程。同时,公司也在关注并布局国内HBM产业链市场机会,积极推动新客户的送样评测。

小结
随着HBM(高带宽存储器)封装技术的快速渗透及AI算力需求的爆发式增长,Low-α球铝需求正快速放量。与此同时,国产替代进程已正式启动,完成了从0到1的实验室突破及中试验证,目前正处于向“1到10”规模化生产与客户端全面验证的关键阶段。但要真正实现对日本企业的全面追赶与超越,一方面需加快上游高纯铝原料的国产化攻关,降低对进口原料的依赖;另一方面则需持续优化工艺稳定性、提升产品批次一致性。唯有如此,方能赢得国际头部客户的长期订单。
粉体圈Corange整理
